Чувствительность
Чувствительность фотоприемника — это полный КПД преобразования световой мощности в электрический ток:

где ф0 — поток световой энергии, т. е. произведение числа фотонов (в единицу времени) на энергию одного фотона. С учетом формулы можно переписать выражение для чувствительности фотоприемника в виде

Отсюда следует, что чувствительность фотоприемника тем выше, чем больше квантовый выход г\, т. е. чем больше доля светового потока, поглощаемая в активной зоне (рис. 13.3).

Если учесть противоречивые требования, предъявляемые к ширине активной зоны, то ее оптимальное с точки зрения полосы пропускания значение будет таким:

Такая ширина активной зоны обеспечивает квантовый выход ~60% и чувствительность на длине волны 1 мкм, равную 5 = 0,5 А/Вт.
P-i-n-ФОТОДИОДЫ
p-i-n-ФОТОДИОДЫ
В фотодиоде необходимо совместить область поглощения света с обедненным слоем, чтобы одновременно удовлетворить требованиям быстродействия и высокого квантового выхода. Это реализуется в фотодиодах с p-i-n-структурой, которые являются наиболее распространенным типом фотодетекторов.
Структура и принцип действия p-i-n-фотодиода пояснены на рис. 11.15. Он состоит из низкоомной п+-подложки, слабо легированного (собственного) i-слоя и тонкого низкоомного p+-слоя толщиной до 0,3 мкм, через которые производится освещение. Низкоомные n+- и р+-области выполняют роль контактов (а). Наличие центрального высокоомного i-слоя приводит к увеличению ширины слоя объемного заряда (б) по сравнению с обычным p-n-переходом. Его толщина di, подбирается так, чтобы поглощение света происходило в этом i-слое (в), совпадающем со слоем объемного заряда. При приложении обратного смещения U обедненный слой распространяется на всю i-область. Это приводит к уменьшению емкости перехода, повышению чувствительности и быстродействия. Падающий свет, затухая по экспоненциальному закону с постоянной, определяемой показателем поглощения кш для данной длины волны, вызывает генерацию носителей заряда преимущественно в i-слое. Фотогенерированные носители ускоряются электрическим полем до скорости насыщения дрейфа (~ 105 м/с), поскольку напряженность электрического поля в обедненном слое обычно превышает 1 кВ/см. Эта скорость дрейфа примерно на три порядка превышает скорость диффузии. Поэтому p-i-n фотодиод конструктивно выполняется так, чтобы мак-

симально уменьшить долю поглощенного света вне i-слоя. С этой целью переход формируется у самой поверхности кристалла (как это реализуется в кремниевых фотодиодах), или используется эффект широкозонного окна (как в p-i-п-гетерофотодиодах).
В стационарном режиме плотность полного фототока, протекающего через обратносмещенный p-i-n-переход, можно разбить на две части:

где Jдр — плотность дрейфового тока, обусловленного генерацией носителей в i-слое толщиной d, а Jдифф — плотность диффузионного тока, обусловленного генерацией носителей в объеме полупроводника за пределами обедненного слоя и их последующей диффузией к области объемного заряда. Будем считать толщину приповерхностного слоя p+-типа существенно меньше
1/ kw Током термической генерации можно пренебречь. Тогда в соответствии с рис. 11.15, в скорость генерации электронно-дырочных naр:

где Go определяется потоком падающих фотонов Фw=Iw/hw, коэффициентом оптического отражения Rw и площадью окна А как:

При этих условиях дрейфовый ток:

Плотность диффузионного тока Jдифф определяется через концентрацию неосновных носителей (в нашем случае — дырки в n-области) и их коэффициент диффузии Dp как

В свою очередь концентрация неосновных носителей (дырок) находится из одномерного диффузионного уравнения, которое в нашем случае имеет вид:

Здесь tр — время жизни неравновесных носителей, а рn0 — равновесная концентрация дырок. Решая это уравнение с граничными условиями pn=pn0 при z®¥ и pn=0 при z=d, подставляя это решение в находим

где Lp=(Dptp )1/2— диффузионная длина.
Полная плотность фототока получается как

Обычно второе слагаемое, содержащее pn, значительно меньше первого и полный фототок Jф пропорционален потоку фотонов Фw. Получаем выражение для квантовой эффективности

Для достижения высокой эффективности фотодиода необходимо выполнить kwd>>1. Однако при увеличении d будет расти время пролета носителей, которое равно времени их дрейфа через
i-область. Это приведет к уменьшению быстродействия диода. При высокочастотной модуляции интенсивности света появится разность фаз между потоком фотонов и фототоком. Разумный компромисс между быстродействием и квантовой эффективностью достигается при значении ширины области поглощения dt от 1/кw до 2/кw. В кремниевых p-i-n фотодиодах, предназначенных для приема излучения арсенид-галлиевого лазера (l= 0,85...0,92 мкм), это соответствует толщине обедненного слоя d=20...50 мкм. Те же диоды, предназначенные для приема излучения твердотельных неодимовых лазеров (l=1,06 мхм), должны иметь толщину i-слоя d= 500 мкм.
Предельная рабочая частота, ограниченная временем дрейфа носителей через i-область и соответствующая уменьшению фототока на 3 дБ по сравнению со стационарным значением, примерно равна:

где vs — скорость насыщенного дрейфа.
Наибольшее распространение в оптической электронике получили p-i- n фотодиоды, изготовленные на основе высокоомного кремния n-типа. Типичная конструкция кремниевого p-i-n-фотoдиода приведена на рис. 11.16, а. Отметим, что эти диоды просты по своей структуре, обладают хорошей линейностью в широком динамическом диапазоне от десятков пиковатт до десятков милливатт. Они просты в эксплуатации и дешевы. Их спектр фоточувствительности хорошо согласуется со спектром излучения GaAs-лазеров. Все это, вместе взятое, определило широкое использование p-i-n-фотодиодов в оптической электронике для детектирования оптических сигналов, модулированных частотами до гигагерцового диапазона.
Естественно, что для реализации возможностей фотодиода как фотоприемника слабых оптических сигналов его электрические параметры должны быть согласованы с параметрами схемы, обеспечивающей дальнейшее усиление и регистрацию сигнала. Освещаемый фотодиод эквивалентен генератору тока. В простейшей схеме включения, изображенной на рис. 11.16, б, с нагрузочного сопротивления Rн снимается напряжение, пропорциональное фототоку, которое подается на усилитель напряжения. Отношение сигнала к шумовому току на входе будет тем больше, чем больше сопротивление Rн. В сочетании с полевым транзистором такая схема позволяет регистрировать световые мощности на уровне десягков пиковатт. Напомним, что при больших Rн, инерционность приемного тракта может быть ограничена постоянной времени RC.
Вместо обычного усилителя напряжения может быть выбран стандартный операционный усилитель с большим коэффициен-


Поглощение излучения
Поглощение света в веществе описывается экспоненциальным законом :

Параметр а называется показателем поглощения вещества. Обратная ему величина имеет размерность длины и равна тол
 |
щине вещества, при которой световой поток ослабляется в е раз, где е — основание натуральных логарифмов. Это соответствует поглощению около 63% излучения, падающего на вещество. Показатель поглощения а очень сильно зависит от длины волны l, т. е. от энергии падающих фотонов и, значит, от их способности переводить электроны в валентную зону. Из приведенных на рис. 13.2 зависимостей показателя поглощения от длины волны следует, что свет создает заметный фототок только в определенной спектральной области, резко ограниченной с одной стороны критической длиной волны lс, которая соответствует минимальной энергии кванта, необходимой для преодоления запрещенной зоны AW вещества. Критическая длина волны дается формулой

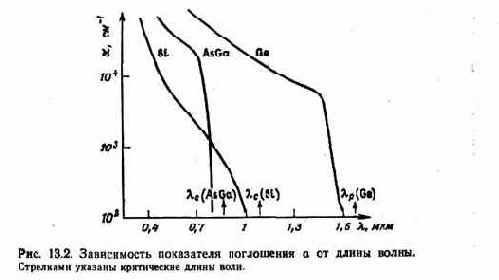
где h — постоянная Планка. Если энергию выразить в электрон-вольтах, а длину волны в
микрометрах, то эта формула принимает вид

Величины AW и lс для ряда используемых на практике полупроводниковых материалов приведены в табл. 13.1, которая служит дополнением к табл. 12.1.

Другая граница фоточувствительности, со стороны коротких длин волн, обусловлена очень сильным поглощением излучения вблизи поверхности образца полупроводника, где очень мало время жизни носителей тока до их рекомбинации.
Принципиальное устройство ГФТ
Принципиальное устройство ГФТ показано на рис. 1( его зонная диаграмма эмиттер — база — на рис. 55. Заштрихованной показана так называемая легированная плоскость, которая представляет собой тонкий (~0,1 мкм) сильно легированный акцепторами (Nа~1О11 см-2) слой, вводимый при резком гетеропереходе для снижения рекомбинационных потерь на границе раздела база — эмиттер. Широкозонный гетероэмиттер является прозрачным окном для излучения, поглощаемого в относительно узкозонной базе. Наличие пичкового потенциального барьера Dxc для неосковных носителей базы на границе гетероперехода позволяет независимо выбирать уровни легирования эмиттера Na и базы Ns так, чтобы N3<<N6, разделить области поглощения и переноса.


При этом удается достигнуть практически максимальной добротности фотоприемника (— 100 ГГц) при G>100. Гетерофототранзистор — двухполюсный прибор, который не имеет подключенной базы.
Как высокодобротный фотоприемник ГФТ является альтернативой лавинным фотодиодам, отличающейся большей технологичностью и менее жесткими допусками на разброс его параметров, в том числе напряжения смещения. По Ропор ГФТ существенно (на порядки величин) уступает лавинным фотодиодам. Однако для интегрально-оптических схем этот параметр в ряде случаев не является критичным.
Схема включения ГФТ соответствует схеме с общим эмиттером, для которой

где vб , v3 — средние скорости электронов около эмиттерного края базы и дырок около базового края эмиттера соответственно; 5vб/vз<50; Dxv= q(Up—Un)=DEg—DxC— скачок потенциала валентной зоны на границе гетероперехода; Dxс — скачок потенциала для зоны проводимости на границе гетероперехода; DEg = = ЕЭ—Еб — разница ширины запрещенных зон эмиттера и базы (рис. 55). Из выражения следует, что для получения больших G при Nэ/Nб<<1 и Vб/Vэ<50 необходимо выбирать гетеропары, у которых Dxc/Dxc велико и Dxv>>kT. Для AlxGa1-x As/GaAs при x = 0,28 Dxс=0,3 эВ, а Dxv = 0,053 эВ (~2 kT при T=300° С).
При комнатной температуре такой гетеропереход дает сравнительно небольшой выигрыш в G, что вынуждает повышать уровень легирования эмиттера вплоть до NЭ=1017 см-3. Эффективность гетероперехода значительно возрастает, если он плавный. Плавный гетеропереход получают, задавая x=var у перехода. При этом G возрастает примерно в exp (Dxc / kT) раз, что позволяет получать коэффициенты усиления фототока 300—600 при задержке >50 пс.
У гетеропары Gax In1-x_P/GaAs при x=0 величина ступеньки Dxv= 0,29 эВ (~11 kT), а Dxс=0,16 эВ, что позволяет практически нелегировать эмиттер. Могут быть также использованы структуры InGaAsP/InP, в которых в качестве широкозонного эмиттера используется фосфид индия. У двух последних пар в гетерофототранзисторах наблюдается значительный темновой ток, что практически исключает их применение в качестве низкопороговых скоростных фотоприемников. Высокий уровень легирования базы (Nб = IO18—1019 см~3)' позволяет получать объемное время жизни неосновных носителей t0>1 пс. При этом поле в базе Еб = Dxв /qWб= 104 В/см, что превышает пороговые значения для GaAs и InP. При таких полях перенос носителей происходит почти баллистическим путем при Vб= (1,5—2,5) • 107 см/с. При низких уровнях легирования эмиттера снижается его емкость СЭ=N1/2Э, что адекватно снижению уровня шумов приемника. Чтобы при этом не возрастало последовательное сопротивление эмиттера, его толщину уменьшают до нескольких десятых долей микрометра.
Гетерофототранзистор — весьма сложная многослойная структура. Однако она типичная для большинства скоростных высокочувствительных приемников с вертикальной топологией.
В любой из приведенных на рис. 54 структур коэффициент усиления фототока в соответствии с (63) определяется соотношением

— первичный фототок, обусловленный поглощением в активной области прибора доли излучения P0 ,

Здесь hв — квантовый выход внутреннего фотоэффекта; W — толщина активной области; а=1/а — длина поглощения. По определению первичный фототок (65) равен току фотодиода, у которого коэффициент собирания равен hв. Полоса пропускания фотоприемника, ограниченная его инерционностью по выходной электрической цепи, Df=l/2ptp, где tp — время релаксации, зависящее от объемного t0, поверхностного времени жизни носителей фототока, площади фотоприемника, его конструкции. Для линейной кинетики фототока, когда tн=tс=tЭф=tp, tp = 0,35/Df, где tp = t3 определяется как время нарастания (или спада) импульса фототока в пределах от 0,1 до 0,9 его установившегося значения.
В структуре прибора всегда есть размер в направлении движения носителей, который ограничивает его быстродействие временем пролета:

где Vд max<(1—3)Vt=107—108 см/с. Из (66) следует, что для получения малых tnp необходимо сокращать критические длины, увеличивать поля в активной области прибора и выбирать материалы с большой подвижностью носителей. При этом инжектированные излучением носители должны иметь большую подвижность.
В общем случае tпр определяется как дрейфом, так и диффузией носителя. Последняя составляющая появляется тогда, когда излучение поглощается также вне активной области сильного поля. В диодных структурах это означает генерацию электронно-дырочных пар вне области пространственного заряда (ОПЗ). При этом [58] tпр=[WOПЗ +2(Lп + Lр)]/Vднас где Ln , Lp — диффузионные длины неосновных носителей в нейтральных р- и n-областях прибора соответственно; VДНАС — средняя дрейфовая скорость насыщения, определяемая скоростями носителей обоих знаков. Для большинства материалов, применяемых в быстродействующих фотоприемниках, VДНАС = VРНАС =VДНАС.
В выражении tP=tnp + tCX составляющая схемной релаксации tCX= (Rн+Rg)Cg ; Cg, Rg — полные емкость и последовательное сопротивление приемника; Rн — сопротивление нагрузки. При микроминиатюризации фотоприемников, что характерно для фотоприемников интегрально-оптических схем, время tcx уменьшается. Конструкция фотоприемника должна быть такой, чтобы выполнялось неравенство tСX<tnp. Такой оптимизированной диодной структурой является р—i—n-диод, в котором область сильного поля расширена за счет i-области. В режим истощения при напряжениях смещения UCM>W2i /2ee0m0r, Wi=Wt. Если при этом Won3=1/а, то при фронтальном возбуждении практически все излучение будет поглощаться в области сильного поля диода. Таким образом, при h= 0,8—0,9 размеры i-области оказываются тем меньше, чем больше коэффициент поглощения излучения а в данном материале. В соответствии с этим для p=Si с р=104 Ом-см в диапазоне l=0,8—0,9 мкм толщины Wi = 20—50 мкм при Won3 = = 10—20 мкм и Uсм = Uис = 5 В. При этом tр <150 нc и уменьшается с ростом напряжения смещения до единиц наносекунд при UCM = 100 В.
Диапазону длин волн 0,9—1, 6 мкм соответствуют материалы AiiiBv, в частности n-- lnP, -InGaAs, -InGaAsP, для которых условие Wi=1/a при R выполняется уже при толщинах 3— 10 мкм. У этих материалов наблюдаются и самые высокие подвижности носителей, достигающие при комнатных температурах 104 см3/В с. (mn =12600 см2/В с, n- Ino,53Gao,47As, lо=1,3мкм). Для приемников излучения на l<0,9 мкм, в частности на l=0,82 мкм, широко используется GaAs, AlGaAs, для которых хорошо отработаны технологии получения практически всех типов скоростных фотоприемников. Ниже приведены некоторые значения параметров арсенида галлия, достаточные для расчета характеристик фотоприемников на его основе [58].

Плоскостной фотодиод
Эти фотодиоды, в которых поглощение происходит в основном вне обедненного слоя и, следовательно, постоянная времени определяется диффузией носителей. Если предположить, что толщина обедненного слоя мала и большая часть актов образования пар носителей заряда происходит вне этого слоя, то можно провести такой же расчет, как и в предыдущем параграфе. Но теперь временная задержка будет определяться диффузией [формула (13.5)] и мы получим следующее выражение для полосы пропускания:

где по-прежнему е=1/а(l). В случае промежуточных структур, в которых имеются градиенты концентраций, или при плохом согласовании фотоприемника с рабочей длиной волны полоса пропускания будет лежать в пределах

В тех случаях, когда рабочая длина волны и круговая частота модуляции известны заранее, следует одновременно опти-

мизировать и чувствительность и полосу пропускания. На рис. 13.7 приведена зависимость граничной частоты фотодиода от требуемой спектральной области.
Шумы фотодиодов
А. Шумы в отсутствие лавинного усиления
В данном случае фототок пропорционален вызывающей его световой мощности. Такое соотношение выполняется в среднем, поскольку, как показывает более детальный анализ, фототок есть случайная величина, которая, как и всякая другая случайная величина, характеризуется различными моментами распределения вероятностей: средним значением, среднеквадратичным и т. д. Это и понятно, так как ток на выходе фотодиода равен сумме отдельных токов, соответствующих движению носителей заряда, возникающих в разные моменты времени.
Этот шум, который будет добавляться к шумам цепей усиления и обработки информации, искажает сигнал и так же, как потери в оптических волокнах, ограничивает дальность оптической связи.
Обозначим через p(t) мощность светового импульса, падающего на фотодиод, через {tn}--последовательность моментов времени, в которые рождается пара электрон — дырка, а через u(t) — импульс напряжения на нагрузочном резисторе фотодиода, создаваемый парой носителей в момент t = 0). Полное напряжение на нагрузочном резисторе будет равно

где N — полное число пар носителей заряда, генерируемых световым импульсом. Как показано, процесс генерации носителей, с которым связаны случайные переменные {tn} и N, описывается распределением Пуассона с параметром l(t), зависящим от времени. Таким образом, вероятность того, что в промежутке времени (t, t+ T) возникнет п пар носителей заряда, равна

В таком случае среднее напряжение на выходе равно:



Добавленное здесь слагаемое s2t учитывает шумы, главным образом тепловые, которые вносят электронные схемы, включенные на выходе фотодиода.
Положив p(t) = const = р0, можно написать выражение для отношения сигнала к шуму:

Допустим также, что u(t)—импульсный отклик идеального фильтра низких частот с полосой пропускания Df; тогда окончательно получим

Следовательно, существует такое значение световой мощности р0, при котором шум равен сигналу, т. е. S/B = 1 (или О дБ). Такая мощность называется эквивалентной мощностью шума. Чем меньше эквивалентная мощность шума, тем меньше оптическая мощность на входе приемника, необходимая для обеспечения заданного отношения сигнала к шуму. Обычно тепловой шум пропорционален полосе пропускания Df, и поэтому эквивалентная мощность шума измеряется в единицах Вт*Гц-1/2 .
Б. Шумы при наличии лавинного усиления
Полученные выражения показывают ту важную роль, которую играют собственные шумы фотодиода в уменьшении полного отношения сигнала к шуму. Для уменьшения этого влияния можно использовать лавинный фотодиод с внутренним коэффициентом усиления М. Коэффициент усиления — случайная величина, распределение вероятности которой зависит от типа носителя заряда, вызывающего ионизацию. Обозначим через Мn значение коэффициента усиления в момент времени tn когда рождается первая пара электрон — дырка. Полное напряжение на нагрузочном резисторе будет равно

Не вдаваясь в детали довольно сложного расчета, напишем сразу формулу для среднего квадрата:

где M — среднее значение величины Мn , a F(M)— коэффициент шума, характеризующий отклонения от постоянного коэффициента усиления, равного М. При данных условиях выражение (13.25) принимает вид

Аналогичным образом можно определить эквивалентную мощность шума для системы фотодиод — нагрузка. Отметим, что она зависит от коэффициента усиления М. Если предположить, что F(M) = MX то легко показать, что существует оптимальное значение M, при котором эквивалентная мощность шума минимальна.
p-i-n-ФОТОДИОДЫ
В фотодиоде необходимо совместить область поглощения света с обедненным слоем, чтобы одновременно удовлетворить требованиям быстродействия и высокого квантового выхода. Это реализуется в фотодиодах с p-i-n-структурой, которые являются наиболее распространенным типом фотодетекторов.
Структура и принцип действия p-i-n-фотодиода пояснены на рис. 11.15. Он состоит из низкоомной п+-подложки, слабо легированного (собственного) i-слоя и тонкого низкоомного p+-слоя толщиной до 0,3 мкм, через которые производится освещение. Низкоомные n+- и р+-области выполняют роль контактов (а). Наличие центрального высокоомного i-слоя приводит к увеличению ширины слоя объемного заряда (б) по сравнению с обычным p-n-переходом. Его толщина di, подбирается так, чтобы поглощение света происходило в этом i-слое (в), совпадающем со слоем объемного заряда. При приложении обратного смещения U обедненный слой распространяется на всю i-область. Это приводит к уменьшению емкости перехода, повышению чувствительности и быстродействия. Падающий свет, затухая по экспоненциальному закону с постоянной, определяемой показателем поглощения кш для данной длины волны, вызывает генерацию носителей заряда преимущественно в i-слое. Фотогенерированные носители ускоряются электрическим полем до скорости насыщения дрейфа (~ 105 м/с), поскольку напряженность электрического поля в обедненном слое обычно превышает 1 кВ/см. Эта скорость дрейфа примерно на три порядка превышает скорость диффузии. Поэтому p-i-n фотодиод конструктивно выполняется так, чтобы мак-

симально уменьшить долю поглощенного света вне i-слоя. С этой целью переход формируется у самой поверхности кристалла (как это реализуется в кремниевых фотодиодах), или используется эффект широкозонного окна (как в p-i-п-гетерофотодиодах).
В стационарном режиме плотность полного фототока, протекающего через обратносмещенный p-i-n-переход, можно разбить на две части:

где Jдр — плотность дрейфового тока, обусловленного генерацией носителей в i-слое толщиной d, а Jдифф — плотность диффузионного тока, обусловленного генерацией носителей в объеме полупроводника за пределами обедненного слоя и их последующей диффузией к области объемного заряда. Будем считать толщину приповерхностного слоя p+-типа существенно меньше
1/kw Током термической генерации можно пренебречь. Тогда в соответствии с рис. 11.15, в скорость генерации электронно-дырочных naр:

где Go определяется потоком падающих фотонов Фw=Iw/hw, коэффициентом оптического отражения Rw и площадью окна А как:

При этих условиях дрейфовый ток:

Плотность диффузионного тока Jдифф определяется через концентрацию неосновных носителей (в нашем случае — дырки в n-области) и их коэффициент диффузии Dp как

В свою очередь концентрация неосновных носителей (дырок) находится из одномерного диффузионного уравнения, которое в нашем случае имеет вид:

Здесь tр — время жизни неравновесных носителей, а рn0 — равновесная концентрация дырок. Решая это уравнение с граничными условиями pn=pn0 при z®¥ и pn=0 при z=d, подставляя это решение в находим

где Lp=(Dptp )1/2— диффузионная длина.
Полная плотность фототока получается как

Как правило, здесь можно пренебречь вторым слагаемым, содержащим пр0, и тогда плотность полного тока оказывается пропорциональной падающему световому потоку. Она максимальна при двух условиях ае >> 1 и aLn> 1, которые противоречат требованию малой постоянной времени, так как увеличение е влечет за собой увеличение времени перехода. Для оценки влияния времени перехода на постоянную времени можно измерить фазовый сдвиг между фототоком и световым потоком, модулируемым высокой частотой. Для простоты предположим, что внешнее напряжение достаточно велико и поэтому в слое с собственной проводимостью нет свободных носителей заряда, а те носители, которые проходят через него, движутся с предельной скоростью при данном электрическом поле, т. е. v =vs. Обозначив круговую частоту модуляции через wbwl, можно представить световой поток в виде f= fi ехр{iwt}. Вклад, вносимый слоем толщиной dx по оси х, будет равен

если положить а = 0. Следовательно,

где tr = e/vs — время, за которое носитель проходит через обедненный слой. Итак, ток проводимости амплитудно модулирован функцией вида [1—ехр(iwtr)]/iwtr график которой представлен на рис. 13.5. Если пренебречь влиянием тока смещения, который обусловлен внешним напряжением и не зависит от времени, то нетрудно видеть, что при wtr = 2,4 эта функция умень
 |
-
шается на 3 дБ. Следовательно, полоса пропускания на уровне 3 дБ будет равна

Отсюда следует, что хороший компромисс между требованиями быстродействия и чувствительности достигается при е= 1/а.
Влияние диффузии
Предположим, что толщина слоя объемного заряда мала по сравнению с длиной поглощения L = 1/а(l). Тогда большая часть пар электрон — дырка будут перемещаться под действием диффузии и только те из них, которые достигнут обедненной зоны, дадут вклад в фототок. Следовательно, полезными будут те пары носителей заряда, которые генерируются на расстоянии, меньшем диффузионной длины, от обедненной зоны. Можно ввести понятие скорости диффузии носителей [202], которая пропорциональна логарифмической производной от локальной концентрации носителей заряда С(х):

Здесь D — коэффициент диффузии, который зависит от типа рассматриваемых носителей заряда . Если концентрация носителей распределяется по экспоненциальному закону, то скорость диффузии Vдифф — постоянная величина, равная произведению Da. Если предположить, что полезная толщина полупроводника е равна длине поглощения, то легко найти время, за которое носители ее проходят:

Влияние диффузии меньше, если р — n-переход расположен близко от поверхности и если велика толщина слоя объемного заряда.
Гетерофототранзисторы.
Весьма перспективными для интегрально-оптических и оптоэлектронных схем оказываются биполярные фототранзисторы с широкозонным гетероэмиттером — гетерофототранзисторы (ГФТ), реализация которых стала возможной благодаря успехам эпитаксиальной технологии.

Улучшение характеристик фотодиодов.
Уменьшив степень легирования слоя N-типа, можно увеличить ширину слоя объемного заряда при том же рабочем напряжении. В пределе мы получаем беспримесный материал с собственной проводимостью (обозначаемый буквой /), к которому добавляется слой материала N-типа с малым удельным сопротивлением для обеспечения омического контакта. Такова структура PIN, обеспечивающая квантовый выход, близкий к единице, и очень высокую чувствительность.
Можно также повысить напряжение на фотодиоде до уровня, при котором возможно лавинное усиление. Тогда ширина обедненного слоя будет определяться внешним напряжением и удельным сопротивлением материала (при постоянном напряжении величина е пропорциональна корню квадратному из удельного сопротивления материала). Кроме того, чем больше ширина обедненного слоя, тем меньше емкость р — n перехода и тем меньше постоянная времени фотодиода.
Основные характеристики фотодиодов 2.
